научное издание МГТУ им. Н.Э. Баумана
НАУКА и ОБРАЗОВАНИЕ
Издатель ФГБОУ ВПО "МГТУ им. Н.Э. Баумана". Эл № ФС 77 - 48211. ISSN 1994-0408
# 03, март 2012
УДК 551.501
НИИ РЛ МГТУ им. Н.Э. Баумана
В последнее время упорядоченные металлические наноструктуры вызывают повышенный интерес в связи с их возможными применениями в одном из направлений нанофотоники - наноплазмонике, основанной на использовании различных типов плазмон-поляритонов [1]. Создание упорядоченных металлических наноструктур и контроль их параметров является сложной технологической задачей. Первым технологическим этапом этой задачи является напыление тонкого металлического покрытия на диэлектрическую подложку. В качестве металла (для задач, использующих эффект поверхностного плазмонного резонанса, который можно наблюдать только на границах раздела металл-диэлектрик) оптимальным по целому ряду причин считается выбор золота (см., например, [1]). В качестве диэлектрической подложки выбирается кварц по причине высокого коэффициента пропускания и отсутствия дисперсии диэлектрической проницаемости в видимом и ближнем инфракрасном диапазоне.
Нанесение тонкой пленки золота на кварцевую подложку происходит обычно с использованием метода магнетронного распыления, а толщина тонкой пленки золота контролируется непосредственно в процессе ее получения ( in situ методы). Для контроля тонких металлических пленок наиболее используемым in situ методом на сегодняшний день является метод рентгеновской рефлектометрии (см., например, [2-4]). Этот метод позволяет проводить неразрушающий контроль; измерения могут проводиться как в вакууме, так и в среде рабочего газа; источник и детектор рентгеновского излучения вынесены за пределы вакуумного объема.
Конкуренцию методу рентгеновской рефлектометрии может составить лазерный рефлектометрический метод, который обладает практически всеми положительными качествами метода рентгеновской рефлектометрии и потенциально может быть реализован в виде менее сложного (а значит и менее дорогого) оборудования. Лазерный рефлектометрический метод, конечно, не пригоден для контроля металлических пленок с толщиной сотни нанометров и более, однако он вполне может быть использован для измерения пленок с толщиной единицы нанометров – десятки нанометров.
Ниже исследуются возможности лазерного рефлектометрического метода измерения толщины металлических нанопленок (на примере нанопленок золота на кварцевой подложке).
Лазерный рефлектометрический метод измерения толщины пленок на подложке является существенно более простым (по сравнению с другими методами), использует только информацию о коэффициенте отражения или (и) пропускания трехслойной системы "воздух (вакуум) - пленка - подложка" и достаточно подробно исследован для тонких прозрачных пленок (см., например, [5-7]).
Считаем, что пленка - металлическая с большим показателем поглощения, излучение падает из воздуха (вакуума) вертикально вниз на систему "пленка - подложка" с плоскопараллельными границами (см. рис. 1). Подложка имеет большую толщину и отражением от нижней ее поверхности можно пренебречь. Перпендикулярное падение лазерного луча на подложку с пленкой в большинстве случаев упрощает использование рефлектометрического метода во встраиваемой в технологическое оборудование аналитической аппаратуре. Для измерений используется только одна длины волны излучения ![]() .
.
Положим показатель преломления вакуума (воздуха) равным единице ![]() , а показатель поглощения - равным нулю
, а показатель поглощения - равным нулю ![]() .
.
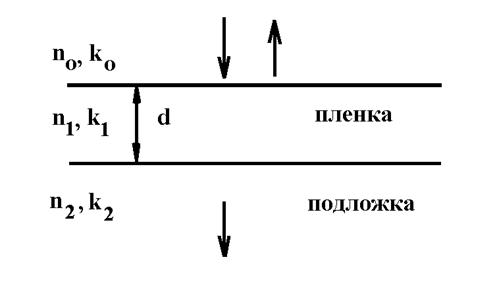
Рис. 1. Схема измерения
При вертикальном падении излучения коэффициент отражения системы "воздух (вакуум) - пленка - подложка" ![]() определяется следующим выражением (см., например, [8]):
определяется следующим выражением (см., например, [8]):
 , (1)
, (1)
где:
 ;
; ![]() ;
;  ;
;
![]() - толщина пленки;
- толщина пленки;
![]() ,
, ![]() – показатели преломления и поглощения пленки золота на длине волны
– показатели преломления и поглощения пленки золота на длине волны ![]() ;
;
![]() ,
, ![]() – показатели преломления и поглощения кварцевой подложки на длине волны
– показатели преломления и поглощения кварцевой подложки на длине волны ![]() .
.
Как видно из формулы (1) коэффициент отражения ![]() сложным образом (из-за интерференции излучения, отраженного от границ раздела «воздух – пленка» и «пленка – подложка») зависит от длины волны излучения
сложным образом (из-за интерференции излучения, отраженного от границ раздела «воздух – пленка» и «пленка – подложка») зависит от длины волны излучения ![]() , толщины пленки
, толщины пленки ![]() и оптических характеристик пленки и подложки. Эффект интерференции приводит к тому, что результат измерения величины коэффициента отражения
и оптических характеристик пленки и подложки. Эффект интерференции приводит к тому, что результат измерения величины коэффициента отражения ![]() на длине волны
на длине волны ![]() в общем случае не определяет однозначно толщину пленки
в общем случае не определяет однозначно толщину пленки ![]() . Это вызывает необходимость разработки сложных (многоспектральных и многоугловых) методов измерения оптических характеристик пленки.
. Это вызывает необходимость разработки сложных (многоспектральных и многоугловых) методов измерения оптических характеристик пленки.
Однако в случае нанопленок (в диапазоне толщин пленки 1 – 100 нм ) задача сильно упрощается, так как в этом диапазоне толщин измеренный коэффициент отражения ![]() однозначно (при известных показателях преломления и поглощения пленки и подложки) определяет толщину пленки. В этом случае толщину пленки можно определить непосредственно из измерений коэффициента отражения
однозначно (при известных показателях преломления и поглощения пленки и подложки) определяет толщину пленки. В этом случае толщину пленки можно определить непосредственно из измерений коэффициента отражения ![]() , численно решая (относительно
, численно решая (относительно ![]() ) уравнение:
) уравнение:
![]() (2)
(2)
или
![]() , (3)
, (3)
где:
![]() - измеренное значение коэффициента отражения трехслойной системы "вакуум (воздух) – пленка золота – кварцевая подложка".
- измеренное значение коэффициента отражения трехслойной системы "вакуум (воздух) – пленка золота – кварцевая подложка".
Значение ![]() (см. формулу (1)) определяется показателями преломления и поглощения пленки золота и кварца, которые известны в широком спектральном интервале (от ультрафиолетового до среднего инфракрасного диапазона) [9] (см. рисунки 2, 3).
(см. формулу (1)) определяется показателями преломления и поглощения пленки золота и кварца, которые известны в широком спектральном интервале (от ультрафиолетового до среднего инфракрасного диапазона) [9] (см. рисунки 2, 3).
Выбор наилучшей (с точки зрения обеспечения наименьшей погрешности измерений толщины пленки) длины волны излучения ![]() лазерного измерителя не является тривиальным: показатели преломления и поглощения золота очень сильно зависят от длины волны в видимой и инфракрасной областях спектра (см. рисунок 2).
лазерного измерителя не является тривиальным: показатели преломления и поглощения золота очень сильно зависят от длины волны в видимой и инфракрасной областях спектра (см. рисунок 2).
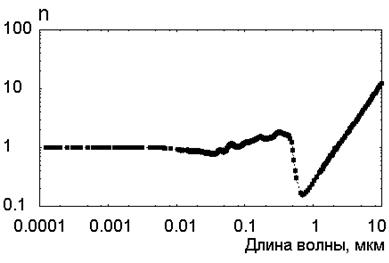
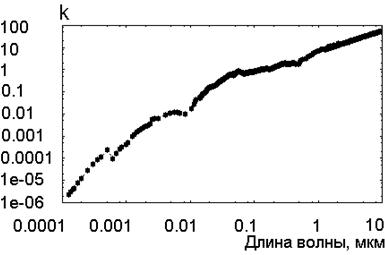
Рис. 2. Спектральная зависимость показателей преломления и поглощения золота
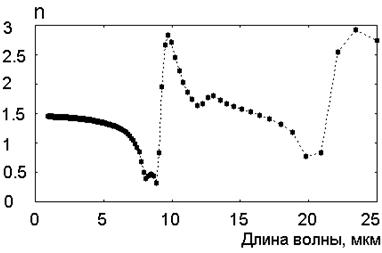
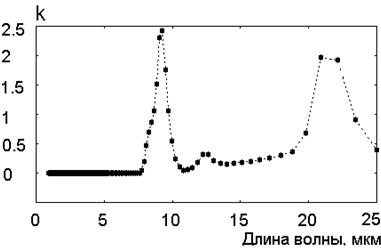
Рис. 3. Спектральная зависимость показателей преломления и поглощения кварца
В статье использовались следующие длины волн излучения: 1550; 1310; 830; 808; 685; 650; 515; 488; 473; 460; 457; 395; 353; 308; 266; 222 нм. Это длины волн серийно выпускаемых лазеров (лазерные диоды видимого и ближнего инфракрасных диапазонов и эксимерные лазеры УФ диапазона). Использование длины волны, соответствующей серийно выпускаемым лазерам, позволит разработать недорогой лазерный измеритель, подходящий для использования в технологическом оборудовании по созданию тонких металлических пленок.
На рисунках 4 - 8 и в таблице 1 приведены результаты расчетов и математического моделирования.

а
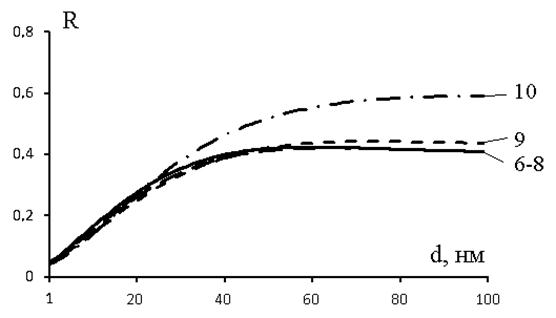
б

в
Рис. 4. Зависимость коэффициента отражения от ![]() для диапазона толщин 1 – 100 нм
для диапазона толщин 1 – 100 нм

а
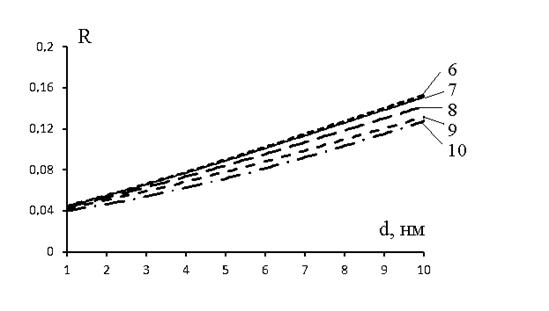
б
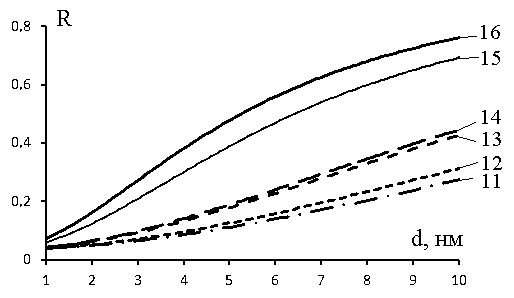
в
Рис. 5. Зависимость коэффициента отражения от ![]() для диапазона толщин 1 – 10 нм
для диапазона толщин 1 – 10 нм
На рисунках 4а, 4б, 4в и 5а, 5б, 5в показана зависимость коэффициента отражения ![]() от толщины пленки
от толщины пленки ![]() (для рисунка 4 диапазон толщин 1 – 100 нм, для рисунка 5 диапазон толщин 1 – 10 нм ).
(для рисунка 4 диапазон толщин 1 – 100 нм, для рисунка 5 диапазон толщин 1 – 10 нм ).
На рисунках: 1 – 222 нм, 2 – 266 нм, 3 – 308 нм, 4 – 353 нм, 5 – 395 нм, 6 – 457 нм, 7 – 460 нм, 8 – 473 нм, 9 – 488 нм, 10 – 515 нм, 11 – 650 нм, 12 – 685 нм, 13 – 808 нм, 14 – 830 нм, 15 – 1310 нм, 16 – 1550 нм.
Из рисунка 4 хорошо видно, что лазерный рефлектометрический метод в принципе позволяет (используя зависимость коэффициента отражения ![]() от толщины пленки
от толщины пленки ![]() ) проводить измерения толщины нанопленок золота на кварцевой подложке в диапазоне толщин от 1 нм до толщин ~ 50 нм. При этом очевидно, что точность определения толщины пленки по значению коэффициента отражения будет зависеть от крутизны функции
) проводить измерения толщины нанопленок золота на кварцевой подложке в диапазоне толщин от 1 нм до толщин ~ 50 нм. При этом очевидно, что точность определения толщины пленки по значению коэффициента отражения будет зависеть от крутизны функции ![]() - чем меньше крутизна этой кривой, тем больше погрешность измерения толщины пленки
- чем меньше крутизна этой кривой, тем больше погрешность измерения толщины пленки ![]() .
.
Из рисунков 4 и 5 хорошо видно, что для разных диапазонов измеряемых толщин кривые с максимальной крутизной зависимости ![]() будут соответствовать разным (и сильно отличающимся) длинам волн лазерного измерителя:
будут соответствовать разным (и сильно отличающимся) длинам волн лазерного измерителя:
- для диапазона толщин 1 – 10 нм наибольшая крутизна зависимости ![]() обеспечивается при использовании длин волн излучения 1310 и 1550 нм;
обеспечивается при использовании длин волн излучения 1310 и 1550 нм;
- для диапазона толщин 5 – 50 нм наибольшая крутизна зависимости ![]() обеспечивается при использовании длины волны излучения 515 нм (и несколько меньшая, но близкая к ней на длинах волн 457, 460, 473, 488 нм).
обеспечивается при использовании длины волны излучения 515 нм (и несколько меньшая, но близкая к ней на длинах волн 457, 460, 473, 488 нм).
Исследование возможностей лазерного рефлектометрического метода измерения толщины нанопленок золота на кварцевой подложке проводилось методом математического моделирования. При математическом моделировании формировались случайные реализации данных «измерений» коэффициента отражения ![]() , при этом относительное среднеквадратическое значение погрешностей измерения коэффициента отражения
, при этом относительное среднеквадратическое значение погрешностей измерения коэффициента отражения ![]() полагалось равным 1 %. Для восстановления толщины пленки по данным «измерений» проводилось численное решение уравнения (3).
полагалось равным 1 %. Для восстановления толщины пленки по данным «измерений» проводилось численное решение уравнения (3).
На рисунке 6 для примера показаны реализации восстановленных по данным «измерений» (на нескольких длинах волн: 1 – 395 нм, 2 – 515 нм, 3 – 1550 нм) значений толщины пленки ![]() в зависимости от заданного значения толщины пленки
в зависимости от заданного значения толщины пленки ![]() в диапазоне толщин 1 – 100 нм. Из рисунка хорошо видно, что вид реализаций сильно зависит от используемой длины волны излучения.
в диапазоне толщин 1 – 100 нм. Из рисунка хорошо видно, что вид реализаций сильно зависит от используемой длины волны излучения.

Рис. 6. Реализации восстановленных по данным «измерений» на нескольких длинах волн значений толщины пленки
На рисунках 7 и 8 показаны примеры случайных реализаций ошибок восстановления (по данным «измерений») толщины пленки  на всех исследуемых длинах волн (для рисунка 7 диапазон толщин 1 – 100 нм, для рисунка 8 диапазон толщин 1 – 10 нм ).
на всех исследуемых длинах волн (для рисунка 7 диапазон толщин 1 – 100 нм, для рисунка 8 диапазон толщин 1 – 10 нм ).

а
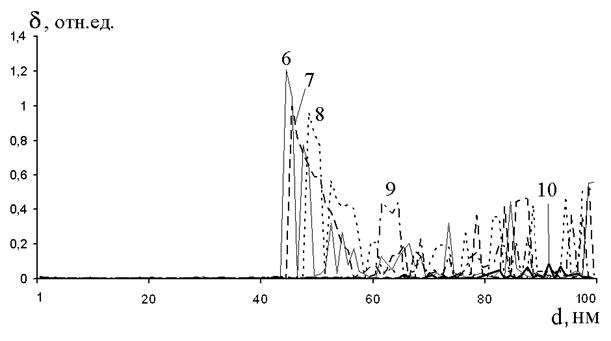
б

в
Рис. 7. Реализации ошибок измерения толщины пленки для диапазона толщин 1 – 100 нм

а

б

в
Рис. 8. Реализации ошибок измерения толщины пленки для диапазона толщин 1 – 10 нм
Обозначения кривых (1 - 16) на рисунках 7 и 8 те же, что и на рисунках 4 и 5.
В таблице 1 для погрешности измерения коэффициента отражения пленки 1% и интервалов измеряемых толщин 1 – 5 нм и 5-50 нм представлены: значения ![]() - средних (по интервалу измеряемых толщин и 1000 реализациям шума измерения) погрешностей
- средних (по интервалу измеряемых толщин и 1000 реализациям шума измерения) погрешностей ![]() определения толщины пленки толщины пленки из данных «измерений» и значения Р – вероятности того, что ошибка измерения не превысит 0,003 (0,3 %).
определения толщины пленки толщины пленки из данных «измерений» и значения Р – вероятности того, что ошибка измерения не превысит 0,003 (0,3 %).
Таблица 1.
Средние значения погрешностей ![]() определения толщины пленки.
определения толщины пленки.
Длина волны излучения, нм | Интервалы измеряемых толщин, нм | |||
1 - 5 | 5 - 50 | |||
| Р |
| Р | |
222 | 0,00373 | 0,494 | 0,18775 | 0,235 |
266 | 0,00332 | 0,541 | 0,14854 | 0,259 |
308 | 0,00327 | 0,541 | 0,15386 | 0,279 |
353 | 0,00351 | 0,515 | 0,16124 | 0,319 |
395 | 0,00363 | 0,509 | 0,14802 | 0,368 |
457 | 0,00412 | 0,460 | 0,09332 | 0,476 |
460 | 0,00417 | 0,454 | 0,08409 | 0,484 |
473 | 0,00439 | 0,435 | 0,02602 | 0,520 |
488 | 0,00472 | 0,417 | 0,00321 | 0,575 |
515 | 0,00518 | 0,404 | 0,00253 | 0,668 |
650 | 0,00296 | 0,652 | 0,00417 | 0,543 |
685 | 0,00264 | 0,692 | 0,00493 | 0,503 |
808 | 0,00202 | 0,780 | 0,00792 | 0,394 |
830 | 0,00197 | 0,790 | 0,00851 | 0,381 |
1310 | 0,00156 | 0,862 | 0,02340 | 0,204 |
1550 | 0,00163 | 0,850 | 0,03384 | 0,161 |
Результаты математического моделирования приведенные в таблице показывают, что наилучшими (с точки зрения минимизации погрешности  ) являются:
) являются:
- длины волны 1310 и 1550 нм для диапазона измеряемых толщин 1 – 5 нм; погрешность измерения в среднем по диапазону ~ 0,0015 (0,15 %); вероятность того, что погрешность не превышает 0,003 (0,3 %) ~ 85 %.
- длина волны 515 нм для диапазона измеряемых толщин 5 – 50 нм; погрешность измерения в среднем по диапазону ~ 0,0025 (0,25 %); вероятность того, что погрешность не превышает 0,003 (0,3 %) ~ 67 %.

Рис. 9. Структурная схема лазерного измерителя толщины металлических пленок
Поэтому наиболее рациональным представляется использование в составе измерителя двух лазерных диодов на длинах волн ![]() (515 нм) и
(515 нм) и ![]() (1310 или 1550 нм), что дает возможность проводить измерения для разных диапазонов толщин пленки с минимально возможной погрешностью (см. рис. 9, где приведена возможная структурная схема лазерного измерителя толщины металлических пленок).
(1310 или 1550 нм), что дает возможность проводить измерения для разных диапазонов толщин пленки с минимально возможной погрешностью (см. рис. 9, где приведена возможная структурная схема лазерного измерителя толщины металлических пленок).
Таким образом, результаты математического моделирования показывают, что лазерный рефлектометрический метод позволяет находить толщину нанопленок золота на кварцевой подложке при погрешностях измерения коэффициента отражения пленки 1 % со средней погрешностью ~ 0,15 % в диапазоне толщин пленок 1 – 5 нм и со средней погрешностью ~ 0,25 % в диапазоне толщин пленок 5 – 50 нм.
Работа поддержана грантом РФФИ 11-02-12283-офи-м-2011.
Литература
1. Наноструктурированные метаматериалы. Получение и характеризация. К.В. Шульга [и др.] // Материалы VII Международной научно-технической конференции, 23 – 27 ноября 2010 г. МОСКВА INTERMATIC – 2010. ч.2. М.:МИРЭА. С. 11-12.
2. Егоров А.А. Внутрикамерная диагностика методом рентгеновской рефлектометрии параметров наноразмерных плёнок напыляемых магнетронным методом в режиме осаждения кластеров. 2009. http://nuclphys.sinp.msu.ru/school/s09/09_04.pdf.
3. Baranov A.M., Kondrashov P.Ε., Smirnov I.S. In situ x-ray reflectivity for thin -film deposition monitoring and control // Solid State Technology. 1999. N5.Р. 53-58.
4. Определение параметров многослойных наноструктур с помощью двухволновой ренгеновской рефлектометрии / Н.Л. Попов [и др.] // Физика и техника полупроводников. 2003. Т. 37,Вып. 6. С. 700-705.
5. Y. Beaudoin, M. Chaker, T.W. Johnston, H. Pepin. Laser reflectometry in situ measurement of lead zirconate titanate film growth [и др.] // Applied optics. 1997. V. 36, N.3. P. 655-657.
6. Photometric methods for determining the optical constants and the thicknesses of thin absorbing films: criteria for precise and unambiguous determination of n, k, and d in a wide spectral range / T. Babeva [et al.] // Applied Optics. 2001. V. 40, N 16. P. 2682-2686.
7. Лазерный рефлектометрический метод измерения толщины и оптических характеристик тонких пленок в процессе их роста / Белов М.Л. [и др.] // Вестник МГТУ. Серия Приборостроение. 2011. N2. С.16-24.
8. И.Я. Гуревич, К.С. Шифрин. Отражение видимого и ИК-излучения света нефтяными пленками на море // Оптические методы изучения океанов и внутренних водоемов. Новосибирск:Наука, 1979. С. 166-176.
9. http://refractiveindex.info.
Публикации с ключевыми словами: лазер, измерение толщины пленки, рефлектометрический метод, пленка золота, кварцевая подложка
Публикации со словами: лазер, измерение толщины пленки, рефлектометрический метод, пленка золота, кварцевая подложка
Смотри также:
Тематические рубрики:
| Авторы |
| Пресс-релизы |
| Библиотека |
| Конференции |
| Выставки |
| О проекте |
| Телефон: +7 (915) 336-07-65 (строго: среда; пятница c 11-00 до 17-00) |
|
||||
| © 2003-2024 «Наука и образование» Перепечатка материалов журнала без согласования с редакцией запрещена Тел.: +7 (915) 336-07-65 (строго: среда; пятница c 11-00 до 17-00) | |||||



